Section Ⅰ
半导体技术发展史的本质就是晶体管尺寸的缩小史。从上世纪七十年代的10微米节点开始,遵循着摩尔定律一步一步走到了今天的5纳米。在这一过程中,每当摩尔定律遭遇困境,总会有新的技术及时出现并引领着摩尔定律继续前行。自22纳米节点上被英特尔首次采用,鳍式场效应晶体管(FinFET)在过去的十年里成了成为了半导体器件的主流结构。然而到了5纳米节点之后,鳍式结构已经很难满足晶体管所需的静电控制。其漏电现象在尺寸进一步缩小的情况下急剧恶化。因此,半导体行业急切需要一个新的解决方案在未来节点中替代鳍式晶体管结构。
尽管各种新型晶体管方案不断地被提出,然而工业界真正青睐的是能够允许他们继续使用现有设备以及技术成果的方案。正是基于这一原因,全环绕栅极晶体管(Gate-All-Around FET)被广泛认为是鳍式结构的下一代接任者。在2019年的三星晶圆制造论坛(Samsung Foundry Forum)上,三星明确表示将会在3纳米节点放弃鳍式结构,转向全环绕栅极技术。在刚刚过去的台积电第26届技术研讨会上,台积电也正式宣布将在2纳米节点引入全环绕栅极技术。目前英特尔仍然受困于7纳米技术难产,尚未给出具体的计划何时引入全环绕栅极技术。但英特尔的首席技术官麦克迈克· 梅伯里博士也在今年的国际VLSI会议上称希望英特尔能在五年之内实现全环绕栅极晶体管的量产。那么这样一个备受各大半导体厂商青睐的晶体管结构究竟是什么样的呢?
平面型晶体管到鳍式结构的转变
要搞清全环绕栅极技术,我们首先要从场效应晶体管(Field Effect Transistor)说起。所谓的晶体管,是指一种等效于水龙头作用的电子器件。水龙头可以用来控制水流的大小以及开关,与之类似晶体管的作用是控制电流的大小与开关。这里面另外一个关键词是场效应,指的是这种对电流的控制是通过施加一个电场来实现的。如下图所示的晶体管结构中,我们可以 通过对栅极施加一个电压从而在通道内部产生一个电场。这个电场的大小可以被用来调节源极和漏记之间电流的大小。也由此可见,决定场效应晶体管效率的一个重要因素就是栅极对通道的控制能力。

根据电阻的定义 R=ρL/S ,我们可以简单估算出源极到漏极之间电阻的大小是和栅极的长度成正比的。栅极越小,在同样的电压下能实现的电流也越大。这是决定晶体管性能的一个关键参数,也因此早期的技术节点往往是根据栅极的长度来命名的。所谓的10微米节点,指的就是栅极的长度最小为10微米。自从引入鳍式晶体管结构之后,技术节点中的数字仅仅是一个营销代号,已经不再和晶体管的任何尺寸直接对应。
上图中另外一个值得注意的地方是通道的长度并不等于栅极的长度。这是因为源极和漏极是通过离子注入(ion-implantation)实现的。在离子注入的过程中,会有离子扩散到栅极下方,形成所谓的扩散层。扩散层的存在,导致了在32纳米节点之后,栅极长度无法进一步缩小(避免漏极和源极之间直接短路)。英特尔也因此在之后的22纳米节点引入了鳍式晶体管。
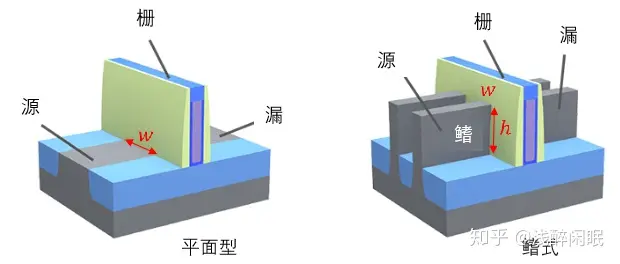
从平面型晶体管过渡到鳍式晶体管,栅极对通道内电场的控制能力大幅提升。原先栅极与通道的接触面积仅仅是由通道的宽度 W 决定的,而在鳍式晶体管中则是由 W+2ℎ 决定。更大的接触面积导致了通道内电流传输的横截面积更大,因而对应的电阻更小电流更高。
鳍式晶体管除了实现对通道更好的控制,另一个重要改进是允许栅极的长度进一步缩小。在平面型晶体管中,源极和漏极的生产是通过离子注入实现的。而在鳍式晶体管中,源极和漏极的则是在栅极做好之后直接在鳍上外延生长(Source-Drain Epitaxy)。此时由于栅极的阻断,不会出现扩散层,也因此不会有短沟效应的问题。
下图是英特尔在22纳米节点首次引入鳍式晶体管时给出的扫描电子显微镜照片。从图中我们可以看到,每一个单元都包含着两组鳍,每组内部各三个。在另外一个方向上,更高的线则是栅线。鳍式晶体管的尺寸缩小的一个重要衡量参数就是鳍线(Fin Line)和栅线(Gate Line)的重复周期。其中鳍线的周期是半导体器件中所有结构中最小的周期,而栅线的周期对整个晶体管的性能有决定性的影响。在22纳米节点,鳍线和栅线的周期分别为60,90纳米。而到了5纳米节点,鳍线和栅线的周期仅为27,54纳米。

5纳米之后,鳍式晶体管将会面临一系列的问题。首先随着栅线之间的间距进一步减小,很难再像之前那样在一个单元内填充多个鳍线。而如果只做一个鳍线的话,生产工艺又很难保证不同器件之间性能一致。因为控制多个鳍线的平均尺寸要远比控制单个鳍线的尺寸容易得多。其次也是更为致命的问题是,随着栅线之间的间距进一步减小,鳍式晶体管的静电问题急速加剧并直接制约晶体管性能的进一步提升。这里所说的静电问题是指鳍式晶体管本身的结构带来的一系列寄生电容以及电阻的问题。例如栅极与栅极之间的寄生电容,栅极与通道之间的寄生电容,栅极与金属电极之间的寄生电容,以及源极与漏极之间的寄生电阻等问题。IMEC之前的模拟表明,当栅线之间的间距缩小至40纳米之后,鳍式晶体管的性能将会趋于饱和。因此,在5纳米之后,工业界迫切需要一个新的结构来替代鳍式晶体管结构,这就带来了全环绕栅极晶体管。
全环绕栅极晶体管
前文中我们提到,工业界迫切需要一个新的晶体管结构来需要满足以下几个需求:
1. 新的结构所需的生产工艺应该与鳍式晶体管相似,可以继续使用现有的设备以及技术成果;
2. 新的结构应实现对通道更好的控制,例如栅极与通道之前的接触面积更大;
3. 新的结构带来的寄生电容和电阻问题应得到显著改善;
全环绕栅极晶体管的出现满足了以上所有需求,从而允许摩尔定律在5纳米之后进一步前进。首先其生产工艺与鳍式晶体管相似,关键工艺步骤几乎一样(这点我们会在之后的文章中进一步讲解)。其次,全环绕栅极晶体管实现了栅极对通道之间的四面环绕,接触面积由 W+2ℎ 提升到了 3×(2W+2ℎ) 。最后由于源极与漏极之间的通道横截面积显著缩小,对应的寄生电容显著降低,而寄生电阻显著增大。
全环绕栅极晶体管的结构如下图所示,根据源极与漏极之间通道的长宽比不同,分为纳米线结构(中图)以及纳米片结构(右图)两种。在早期的研发中,包括IMEC和IBM等机构的早期工艺均采用的是纳米线结构。这是因为较高的长宽比很难控制纳米线与纳米线之间的刻蚀与薄膜生长。随着工艺的逐渐进步,在即将到来的2纳米与3纳米节点,台积电三星等众多厂商将会采用纳米片结构来实现更大的接触面积。而在纳米片之后,工业界可能会重新回到纳米线,因为纳米线可以允许更小间距以及更大的表面积/体积比。
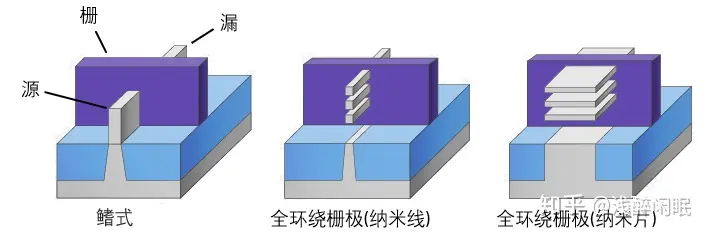
全环绕栅极之后晶体管的发展
根据当前的估计,水平方向上的全环绕栅极晶体管足以维持栅线的周期从54纳米缩减到30~40纳米左右(2~3代节点)。在此之后晶体管的发展,则充满了挑战与不确定性。在当前已知的几种备选方案中,垂直纳米线结构将会把纳米线调整为垂直方向;互补式结构将会把N型晶体管和P型晶体管沿着垂直方向进行堆叠;而堆叠式结构则会把多个栅极在垂直方向上经行堆叠。这些新型的结构理论上均会表现出比水平纳米线/片更加优越的性能,但是他们也需要更为先进的工艺水平才能实现商业化生产。从目前的信息来看,互补式结构最有可能是全环绕栅极晶体管之后的选择。但至于未来究竟会走向何种结构,我们将拭目以待!
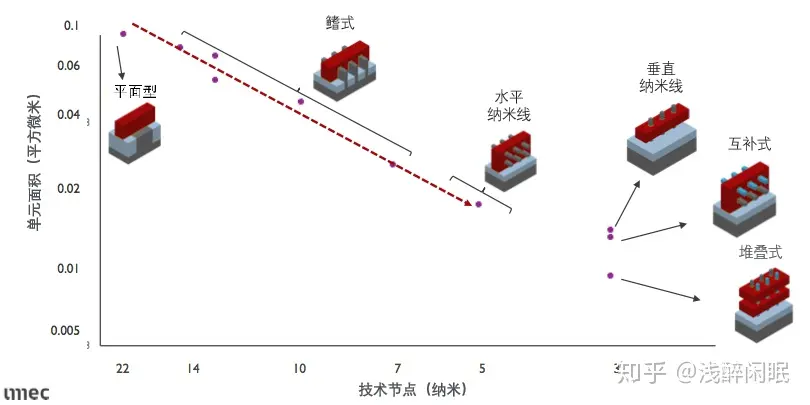
下一代晶体管结构发展(图片来自IMEC)
Section Ⅱ
在前一期的文章中,我们探讨了工业界是如何从平面型晶体管过度到鳍式,再过度到全环绕栅极晶体管的。我们提到工业界青睐全环绕栅极晶体管的一个重要原因是这种新的结构所需的生产工艺与鳍式晶体管非常相似,可以继续使用现有的设备以及技术成果。那么全环绕栅极晶体管究竟是如何生产出来的呢?在本期文章中,我们将会详细介绍其生产工艺。在10纳米以下的先进制程中,生产一颗芯片通常需要几千道工序,因此我们没法详细地介绍每一步工艺。这里我们将重点放在那些和鳍式晶体管不同的步骤进行讨论。如果你还没有看到第一期文章,请点击以下链接阅览:
超晶格外延生长(Superlattice Epitaxy)

第一步:超晶格外延生长的电子显微镜图像(左)及结构示意图(右)。
全环绕栅极晶体管的生产从硅(Si)片基底开始,第一步在Si上外延生长出三个Si-SiGe超晶格结构。这一步在鳍式晶体管的生产工艺中是不需要的。如上图所示,左图中浅色的薄膜以及右图中灰色的薄膜为Si,而深色及蓝色的薄膜则为SiGe。超晶格结构中的每一层厚度均在10纳米以下,最终生产出的厚度会直接决定纳米片通道的高度以及静电性能。
鳍式结构成型(Fin Formation)
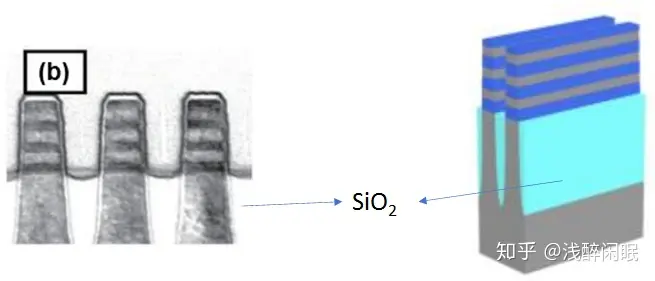
第二步:鳍式结构成型的电子显微镜图像(左)及结构示意图(右)。
在这一步中,我们通过光刻把前一步外延生产的超晶格薄膜做成一个一个周期分布的鳍。上图中新出现的浅蓝色材料是SiO2, 它的作用是隔开相邻的两个晶体管(鳍),因此也被称作浅沟隔绝(STI Shallow Trench Isolation)。这一步工艺最早是从250纳米节点开始引入的,在鳍式晶体管中也有完全一样的生产步骤。通常鳍的周期是芯片所有结构中最小的周期,在5纳米制程中相邻的两个鳍间距已经低至30纳米,是通过自对齐四重曝光实现的(SAQP Self-Aligned Quadruple Patterning)。预计从3纳米开始,这一步将使用EUV单次曝光实现。
栅极成型(Gate Formation)
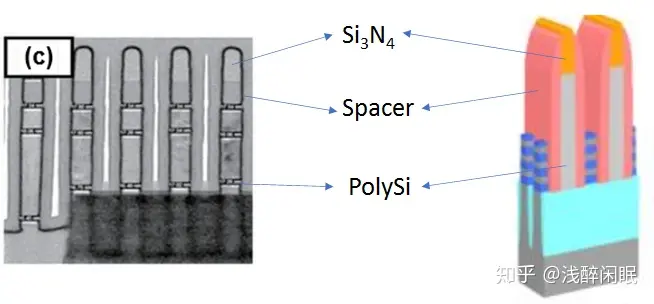
第三步:栅极成型的电子显微镜图像(左)及结构示意图(右)。
在这一步中,我们在与之前的鳍线相垂直的方向上做出周期分布的栅极。栅极所使用的材料是多晶硅(PolySi),栅极的上面附着的是氮化硅(Si3N4),在光刻中起到硬掩膜(Hard Mask)的作用。为了保护栅极避免其与源极漏极短路,栅极表面还会有一层隔离层(Spacer),隔离层的材料通常是氧化硅或者氮化硅。从目前的模拟来看,栅极的周期无法做到40纳米以内,因此自对齐双重曝光即可实现栅极的成型。预计在即将到来的3纳米制程中,这一步将继续使用193纳米沉浸式光刻机进行光刻。
内隔离层成型(Inner Spacer Formation)

第四步:内隔离层成型的流程示意图。
这一步的工艺实际包含三步。首先我们需要把栅极之间鳍全部清理干净,清理出来的空间将来会用来生长源极和漏极。这也是为什么我们说栅极之间的间距很难做到40纳米以下,因为40纳米以下很难再有足够的空间生长源极和漏极。然后我们将暴露在表面的SiGe材料刻蚀进去,这一步将是全环绕栅极晶体管生产中非常关键的一步,刻蚀的程度将直接决定晶体管中有效栅极的大小。最后在刻蚀过的SiGe表面生长内隔离层,与外部的隔离层类似,内隔离层的作用也是防止栅极与之后形成的源极漏极短路。
源极漏极的外延生长(Source Drain Epitaxy)
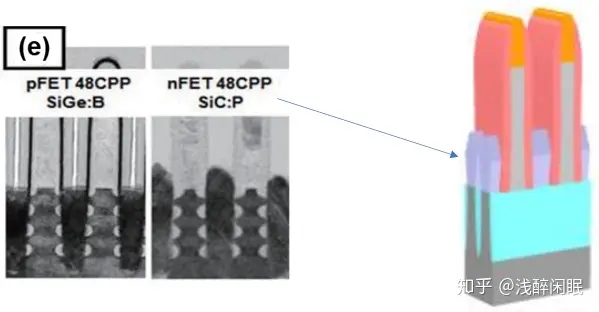
第五步:源极漏极外延生长的电子显微镜图像(左)及结构示意图(右)。
在成功的长出内隔离层保护栅极之后,这一步我们便可以在Si表面外延生长出源极和漏极。如果是P型晶体管,那么源极漏极的材料是硼掺杂的SiGe (SiGe: B)。如果是N型晶体管,那么源极漏极的材料则是磷掺杂的SiC (SiC: P)。这一步的工艺和鳍式晶体管的工艺也是一致的。然而值得注意的是,外延生产会给晶体管的通道施加很大的应变,这种应变对于晶体管的电学性能是非常有利的。但是在3纳米以下的节点,全环绕栅极晶体管的通道是仅仅几纳米厚的薄片,且相邻的薄片之间的距离也只有几纳米,这种应变可能会导致晶体管的严重变形。
通道释放(Channel Release)

第六步:通道释放的电子显微镜图像(左)及结构示意图(右)。
通道释放可以说是全环绕栅极晶体管生产中非常华丽的一步。在经过几百道工序之后,终于在这一步,我们通过选择性的刻蚀把通道释放到半空中,形成三个半悬空的纳米线/纳米片。而之前形成的栅极完全被清理掉了,也因此我们往往称之前的栅极为虚设栅极(Dummy Gate)。在之后的工艺中,我们将会重新在纳米线/纳米片的表面生长出具备高介电常数的绝缘层以及金属栅极(HKMG High-K Metal Gate)。
通道释放也是我们这篇文章介绍的最后一步,之后的生产工艺与鳍式晶体管生产工艺几乎是完全一致的,感兴趣的朋友可以自行了解一下鳍式晶体管的后续工艺。
Section Ⅲ
在前两期的文章中,我们分别介绍了全环绕栅极(Gate-All-Around)晶体管的前身今世,以及这样复杂的结构是如何生产出来的。如果你还没有看过之前的文章,请点击以下链接阅览:
在这一期中,我们将通过Q&A的形式探讨一下当前工业界各方对于全环绕栅极技术的态度以及最新进展。这里需要先声明的是,本篇文章将有大量内容是对未来的预测,而对于未来进行预测总是困难的。因此如果本文与之后实际发生的情况不符,也望能够谅解。
三星能否利用3纳米全环绕栅极技术(Gate-All-Around)弯道超车台积电?
下图是2019年DigiTimes整理的两大工厂未来节点路线图。我们可以看到在19年的时候三星已经计划于2021推出3纳米全环绕栅极技术,而台积电在当时尚未给出其2纳米具体计划。一个计划在2021年切入,而另一个在2022年之前尚未有任何计划,看似三星有望在台积电之前先发全环绕栅极技术,并实现弯道超车。然而真实情况确未必如此。
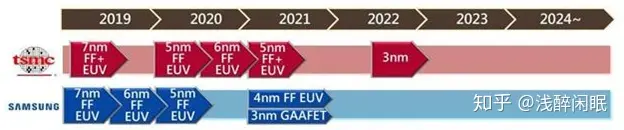
台积电(TSMC)和三星(SAMSUNG)制程路线图(图片来源于DigiTimes)
首先从今年量产的5纳米节点来看,三星5纳米技术的晶体管密度仅为127 MTr/mm2,相比之下台积电的5纳米晶体管密度则高达173 MTr/mm2。两者之间的差距高达30%多。在5纳米差距如此之大的情况下,三星却计划跳过4纳米节点直接进入3纳米以实现赶超。从以往的历史来看,企图通过跳过节点来实现赶超的计划最后往往以失败告终。联华电子在2015年初曾宣布跳过20纳米节点从而在14纳米节点上直接赶上竞争对手,然而其14纳米生产线一直拖到2017年才迟迟上线,即使到了今天14纳米生产线也仅仅占据联华电子3%的总产能。同样格芯也曾在2016年宣布跳过10纳米节点从而在7纳米节点上赶超竞争对手,然而2年之后宣布全面放弃7纳米节点,专注于12/14纳米生产线。所以总结历史经验,三星跳过4纳米节点的行为极有可能以失败告终。其次从今年最新的消息来看,三星已经计划推迟3纳米生产至2022年。而另一边的台积电则是稳扎稳打,先是在八月份正式确认2纳米切入全环绕栅极技术并且宣布2纳米新厂计划。本周又再出报道称台积电计划扩大台中市的工厂为将来的2纳米节点提供额外产能。
综上我们有理由相信在全环绕栅极技术上台积电是领先三星的。然而三星仍然有极大的可能抢先在3纳米节点首发全环绕栅极晶体管。如果三星率先首发全环绕栅极晶体管,我们猜测其性能将会低于台积电的3纳米鳍式晶体管。甚至极有可能是2片纳米片的“破产版”全环绕栅极晶体管。
英特尔:您看我还有机会吗?
难,英特尔会非常难。从2016年英特尔宣布放弃两年一周期的“Tick-Tock”战略起,新的POA三步走战略就像温水煮青蛙一样一步步将其拖入困境。今年七月英特尔宣布7纳米节点再次延期至2022年底甚至是2023年初,彻底地将其困境揭露到世人面前。不光是7纳米难产,直到今天英特尔的10纳米都还有产能及良率问题。也因此,英特尔至今尚未给出具体的计划何时引入全环绕栅极。但英特尔的首席技术官麦克迈克· 梅伯里博士曾在今年的国际VLSI会议上称希望英特尔能在五年之内实现全环绕栅极晶体管的量产。但是从其目前在7纳米和10纳米上遇到的困境来看,前景并不乐观。
IMEC,中科院微电子所又扮演着什么角色?
IMEC(Interuniversity Microelectronics Centre)是校际微电子中心的简称,也是全球最大的独立的微电子研究中心之一。IMEC的研究人员来自各大高校、企业,其中就包括了前文中所说的台积电、三星、以及英特尔。半导体行业制程的演进往往都是由IMEC指明方向,由企业负责技术落地。早在2016年的集成电路研讨会上(2016 Symposia on VLSI Technology & Circuits),IMEC已经演示了完整的全环绕栅极技术(当时还用的是纳米线)的生产工艺并指出全环绕栅极技术将会是鳍式晶体管的下任替代者。
中国科学院微电子研究所是国内最大的微电子研究中心。虽然其对半导体产业的影响力比不上IMEC,但是在先进制程里也积累了庞大的专利资产,包括大量的全环绕栅极技术相关专利。之前的微电子所诉英特尔FinFET专利侵权案,以及微电子所研发垂直纳米环绕栅极晶体管的新闻都可以说明微电子所的重要性。
然而在半导体领域,研发能力并不等于生产能力。对于当前的中国来说,后者重要性要远远大于前者。比如微电子所的那篇研发垂直纳米环绕栅极晶体管的新闻,看似说明中科院已经具备生产2纳米制程以下晶体管的实力,然后事实并非如此。文中的晶体管生产压根没有用到EUV光刻机或者任何先进制程所需的光刻机,而是使用电子束曝光做出来的。电子束曝光的产量非常非常低,仅仅适合研发使用,没法用在工业界。因此那篇文章中的工作仅仅说明微电子所具备研发能力,并不具备生产2纳米制程以下晶体管的能力。
本文摘自 [GAA系列一]详解台积电2纳米制程中的全环绕栅极(Gate-All-Around)晶体管技术 - 知乎 (zhihu.com)